单晶硅缺陷的分析
单晶硅缺陷的分析
摘要:晶体硅中的杂质或缺陷会显著地影响各种硅基器件的性能。用常规化学腐蚀法显示出单晶硅中的缺陷,观察典型的位错。通过实验发现缺陷分布的一般规律:中间尺寸大,密度小,边缘尺寸小,密度大,验证缺陷对杂质的吸收。
硅是全球第一产业--电子信息技术产业以及新能源产业--太阳能光伏电池产业的基础材料[1]。随着网络时代的到来,半导体产业将发展到新的高潮。为适应深亚微米、亚四分之一微米甚至纳米级集成电路的要求,硅单晶材料在增大直径的同时,对其结构、电学、化学特征的研究也将日益深入;缺陷控制、杂质行为、杂质与缺陷的相互作用以及提高晶片的表面质量仍将是工艺技术研究的主攻方向。另外,在光伏工业中广泛采用太阳能电池用单晶硅和铸造多品硅,在这些材料中存在着高密度的位错,金属杂质或晶界等缺陷,而这些缺陷和杂质的交互作用使得太阳能电池的转换效率显著下降,因此观察这些硅材料中缺陷和杂质的交互作用对于采用合适的吸杂工艺提高太阳能电池的转化效率有着十分重要的作用[2]。
由于缺陷影响硅单晶的质量,对器件也有不良影响,我们不得不研究其性质、行为。但是,在研究过程中遇到越来越多的问题:对于已发现的主要缺陷,其机制研究一直没有重大突破;消除和控制方法也还处于探索之中;检测方法、检测手段也有待进一步的提高[3]。
1实验
晶体缺陷的实验观察方法有许多种,如透射电子显微镜、X光貌相技术、红外显微镜及金相腐蚀显示等方法[4]。由于金相腐蚀显示技术设备简单,操作易掌握,又较直观,是观察研究晶体缺陷的最常用的方法之一。在本次实验中,我们就采用金相腐蚀显示法,通过使用不同的腐蚀液和腐蚀方法显示单晶硅中各种不同的缺陷蚀坑,然后用金相显微镜来观察、区分和研究各种蚀坑的形态,定量计数比较缺陷密度大小,并用金相显微摄影仪拍摄各种缺陷的典型照片。
1.1化学腐蚀机理
样品在进行光学检测之前,必须经过腐蚀抛光以显露其缺陷。腐蚀剂的种类繁多,但组分却不外乎氧化剂,络合剂和稀释剂。常用浓HNO3、CrO3溶液或K2Cr2O溶液作氧化剂,氢氟酸(HF)作络合剂,去离子水或冰醋酸充当稀释剂。如果氧化成分多,则抛光作用强;如果络合和稀释成分多,则有利于作选择性腐蚀。
通常用的非择优腐蚀剂的配方为:自腐蚀剂,适用于化学抛光,配方为:HF(40-42%):HNO3(65%)=1:2.5
通常用的择优腐蚀剂主要有以下二种:
(1)Sirtl腐蚀液,先用CrO3与去离子水配成标准液,标准液=50gCrO3+100gH2O,然后配成标准液:HF(40-42%)=1:1
(2)Dash腐蚀液,配方为:HF(40·42%):HNO3(65%):CH3COOH(99%以上)=1:2.5:10
1.2金相显微原理
金相显微镜是通过观察不透明物体的反射光来表征物体的表面特征,不同结构和性能的显微镜存在较大差异,其中有以Nomarski式差动干涉反衬显微镜为代表的高级型金相显微镜。其关键部件是用于分离光束的棱镜,经棱镜分离后,光束变成极化向互相垂直,中心不重合的两束光;由此而引入相差,最后经检偏器后发生干涉。干涉图样能够反映试样的表面是否平整;且不同材料组成的区域,即使有相同的高度和坡度但由于它们对入射波的延迟作用不同,也会产生附加衬度[5]。
1.3图象数据采集
将观察到的缺陷图形通过与显微镜相连的计算机数据采集卡读入计算机,就可以完成晶体缺陷的在线测量,从而大大提高材料检测的效率。

2实验结果及分析
2.1不同腐蚀条件下显示的各种缺陷的比较
在实验过程中我们拍摄到一些典型的缺陷图片,主要包括各种形状的位错,层错及微缺陷等。对于位错来说,不同晶面上的位错坑的形态不一样,例如:位错腐蚀坑的形状在硅单晶<111>晶面呈正三角形腐蚀坑,(100>晶面上呈正方形,<110>晶面上是矩形(较难显示)。下面两幅图很好的说明了这一点:


而同一晶面在不同的腐蚀剂中腐蚀,位错坑的形态也不完全一样;甚至腐蚀长短也影响到位错坑的形态。比如在非择优腐蚀剂(如Dash腐蚀剂)情况下硅单晶<111>面位错坑为圆形的凹坑;在晶向择优腐蚀剂中硅单晶<111)面位错呈三角形锥体,这是由于择优腐蚀剂在晶体中的各个方向的腐蚀速度不同所造成的。如图4、图5所示,硅单晶<111>在被不同的腐蚀液腐蚀后显示出不同的形状。
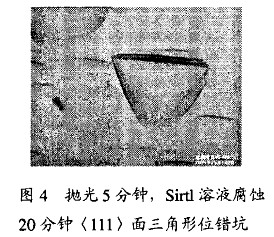

2.2缺陷对杂质的吸收
位错是一种线状的高应力区,有吸收杂质原子的能力,引起沿位错线的局部地区杂质浓度增加。这种作用将严重影响到器件工艺的控制,并从而影响到器件性能和成品率的提高等。


从以上两幅图中可以明显的看到,缺陷存在的地方,有明显的金属色,这是吸收了金属杂质的缘故。这两张图片很好的说明了缺陷对杂质的吸收作用。
2.3缺陷的分布规律
在实验中拍摄到下面一组图片


在硅片的边缘观察到了大量的缺陷,如图8,在硅片的中心则观察到少量的缺陷,如图9,这反应出了单晶硅缺陷分布的规律,即:中心缺陷的尺寸大,密度少;边缘缺陷的尺寸小,密度大。
3结论
应用化学腐蚀硅片然后在金相显微镜下观察,可以对硅片的缺陷做有效的观察。为了得到清晰的图象,选择金相放大400倍最为合适。而化学腐蚀剂的选择应该根据不同的半导体材料及其晶体学属性而定,其中Dash试剂对硅片各向都有良好的腐蚀效果,在简单实验条件下对位错仍然有良好的腐蚀放大效果。在实验过程中我们用常规的化学腐蚀法,显示了单晶硅中的各种典型缺陷,验证了缺陷对杂质的吸收作用,还发现了缺陷分布的规律性,即:中心缺陷的尺寸大,密度少;边缘缺陷的尺寸小,密度大。
上一篇:单晶硅的市场发展
下一篇:单晶硅生产的环境影响






 sales@chinatungsten.com
sales@chinatungsten.com